Наномасштабный монокристаллический карбид кремния на кремнии – новый материал для электроники
В лаборатории ИПМаш РАН открыт, не имеющий мировых аналогов, принципиально новый метод синтеза пленок карбида кремния (SiC) на кремнии (Si), имеющих важное значение для микро- и оптоэлектроники. При традиционных методах выращивания пленок, компоненты из которых растут пленки, поступают на поверхность подложки, состоящей из чужеродного, по отношению к пленке кристаллического материала, из внешней среды. Из-за большого различия в параметрах кристаллических решеток пленка-подложка и отличия, в их линейных термических коэффициентах расширения, в процессе выращивания пленок карбида кремния на кремнии образуется большое количество дефектов, в частности, дислокаций несоответствия. При росте плёнки карбида кремния на кремнии методом разработанным в ИПМаш РАН рост пленки карбида кремния происходит не в результате поступления компонентов, из которых образуется пленка карбида кремния, на поверхность подложки, а в результате замены части атомов кремния на атомы углерода прямо внутри кристаллической решетки исходной матрицы кремния. Этот метод называется – «Метод согласованного замещения атомов». В результате использования данного метода роста, слои карбида кремния на кремнии приобретают новые физические свойства, принципиально отличающиеся от свойств слоев карбида кремния, выращенных традиционными методами. Кратко эти свойства следующие.
Преимущества:
1. Пленки SiC на Si полностью свободны от дислокаций несоответствия. В них присутствуют только дефекты упаковки, сосредоточенные, на границе раздела карбид кремния кремний в слое толщиной порядка 5-10нм.
2. Упругие деформации в пленках SiC на Siотсутствуют. Подложки Si с пленкой SiC, выращенной данным методом не имеет изгибов.
3. Наличие пор в Si под слоем SiC приводит к резкому снижению, вплоть до нуля, термических деформаций, вызванных различием линейных термических коэффициентах расширения пленка–подложка.
4. Метод согласованного замещения атомов позволяет эффективно управлять структурой межфазной границы раздела SiC/Si Можно изменять параметры решетки промежуточного слоя и, тем самым, «подстраивать» параметры под нужную решетку, выращиваемой на поверхности SiC/Si пленки.
5. На межфазной границе раздела SiC–Si кремний переходит в состоянии полуметалла. Это приводит к тому, что в инфракрасной области спектра коэффициент поглощения света становится отрицательным, т.е. граница радела приобретает свойства метаматериала.
6. В слоях SiCна Siнаблюдаются макроскопические квантовые явления при комнатной температуре, в частности наблюдаются осцилляций Ааронова-Бома и осцилляции де-Гааза– ван -Альфвена
7. Пленки SiC на Si обладают магнитным моментом. В пленках SiC, выращенных стандартными методами магнитный момент отсутствует.
8. Под воздействием приложенного продольного тока из пленок SiC на Si испускается, при комнатной температуре, электромагнитное излучение в терагерцовом диапазоне длин волн.
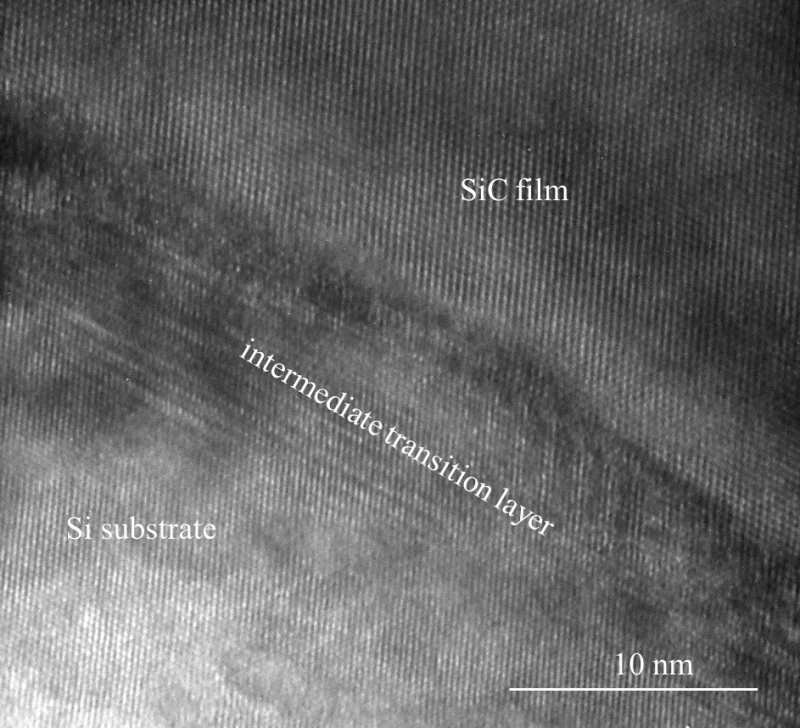
Изображение границы раздела кремниевая подложка–эпитаксиальная плёнка карбида кремния, полученное при помощи высокоразрешающей электронной микроскопии. На изображении хорошо видна укладка атомов кремния и карбида кремния. Видно, что в переходной области присутствуют только дефекты упаковки, а слое карбида кремния нет дислокаций несоответствия.
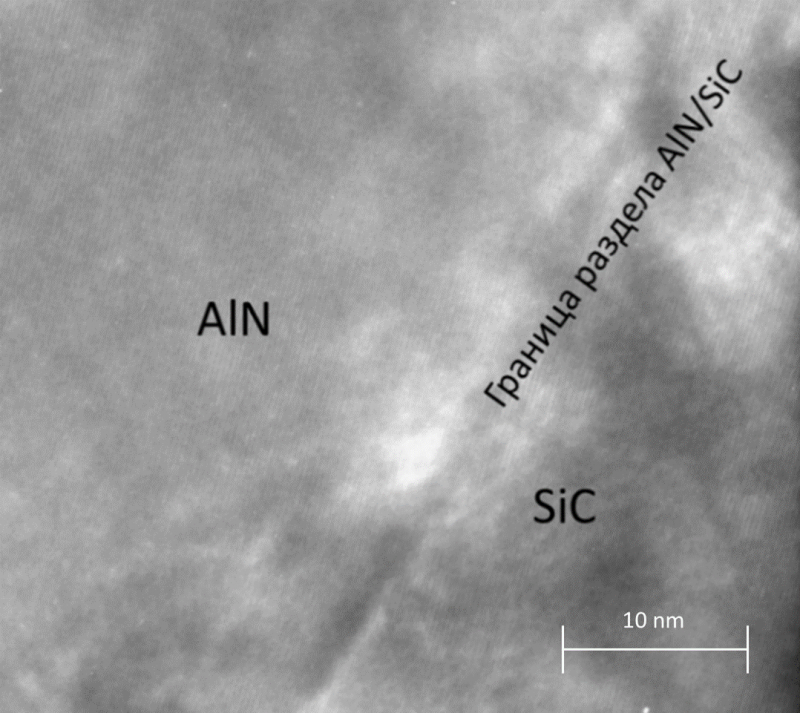
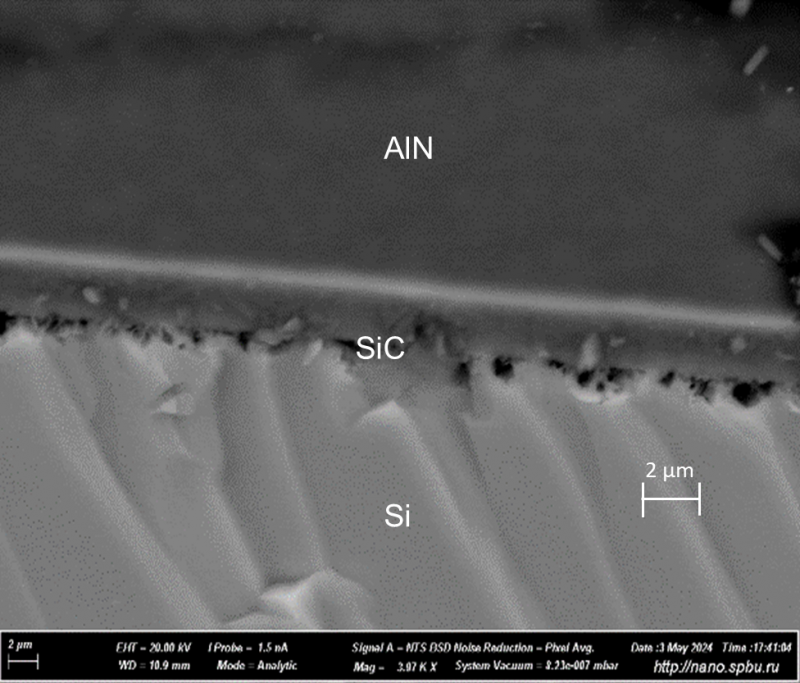
Изображение эпитаксиального слоя нитрида алюминия толщиной порядка 5 мкм, выращенного на такой податливой подложке карбид кремния–кремний без трещин.
На основе созданной технологии, впервые в мировой практике, на поверхности монокристаллических пластин кремния диаметром 4 (100мм) и 6 (150 мм) дюймов были выращены низкодефектные, механически не напряженные и свободные В настоящее время небольшими партиями производим образцы карбида кремния на подложках Si диаметром 2 дюйма (52 мм), 3 дюйма (76 мм),4дюйма (100 мм) и 6 дюймов (150 мм).
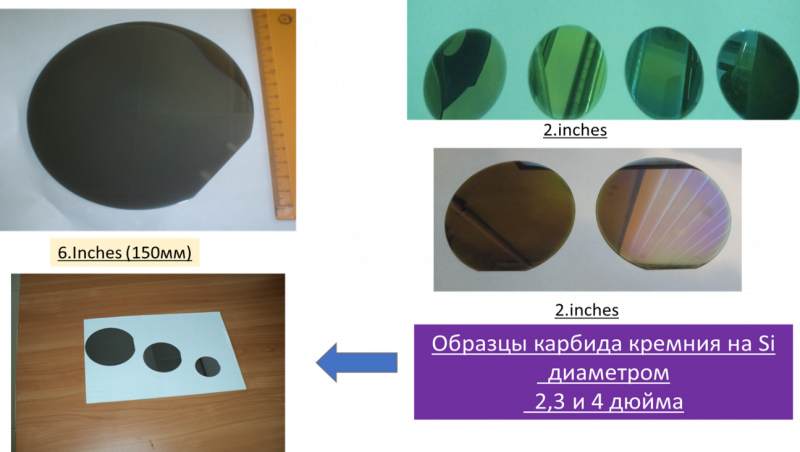
Пластины карбида кремния на кремнии различного диаметра.
В ИПМаш РАН создан Автоматизированный комплекс оснащённый, разработанным в ИПМаш РАН, уникальным ректором синтеза SiC на Si.

В настоящее время введена в строй промышленная, с автоматическим управлением установка для синтеза тонких пленок SiC диаметром до 150 мм методом согласованного замещения атомов. В июне 2025 годов было построено чистое помещения класса ISO7–8 площадью 42 м²..

Пользователи: предприятия электронной промышленности
Контакты: Заведующий лабораторией структурные и фазовые превращения в конденсированных средах ИПМаш РАН, Кукушкин Сергей Арсеньевич sergey.a.kukushkin@mail.ru

